文章內容
覆晶封裝(FCP:Flip Chip Package)

請自行調高解析度
❒ 覆晶封裝的製作流程
覆晶封裝一般都使用「導線載板」與「金屬凸塊(Solder bumps)」,而且可以將金屬凸塊製作在晶片的任何地方,不一定要在四周圍,導線載板上方的金屬接點也可以製作在積體電路封裝外殼的任何位置,而不一定要在四周圍,如<圖一>所示,因此覆晶封裝的接腳數目可以很多。此外,由於覆晶封裝並不打線,因此不需要使用導線架,而改用導線載板;也不使用金線,而改用金屬凸塊。
覆晶封裝的步驟為:在晶片的黏著墊(Bond pad)上方製作「金屬凸塊」;再將晶片反轉加熱使金屬凸塊「全部一次」連接導線載板上方的「金屬連接點」;最後填充強力膠(環氧樹脂)將晶片整個包覆起來以保護晶片。
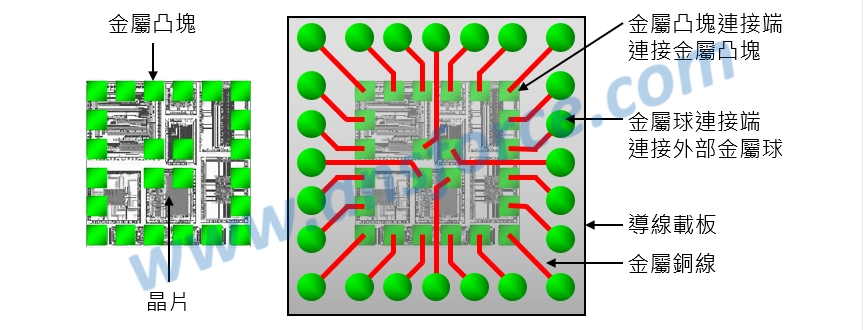
圖一 覆晶封裝技術。
覆晶封裝最大的優點是不需要以打線方式進行內部封裝,因為打線的動作必須「一根一根地」完成非常費時,而覆晶封裝則是將晶片反轉加熱使金屬凸塊「全部一次」連接導線載板上方的金屬連接點,可以在很短的時間內完成連接。
❒ 覆晶封裝的應用
覆晶封裝一般都使用「導線載板」,如<圖二>所示,導線載板主要是和晶片上的金屬凸塊對接,配合封裝外部使用針格陣列(PGA)或球格陣列(BGA)如下:
➤內部覆晶封裝,外部針格陣列(PGA):如<圖二(a)>所示,是目前英特爾(Intel)的中央處理器(CPU)常用的封裝方式。知識力www.ansforce.com。
➤內部覆晶封裝,外部球格陣列(BGA):如<圖二(b)>所示,是目前個人電腦的北橋晶片與南橋晶片經常使用的封裝方式。知識力www.ansforce.com。
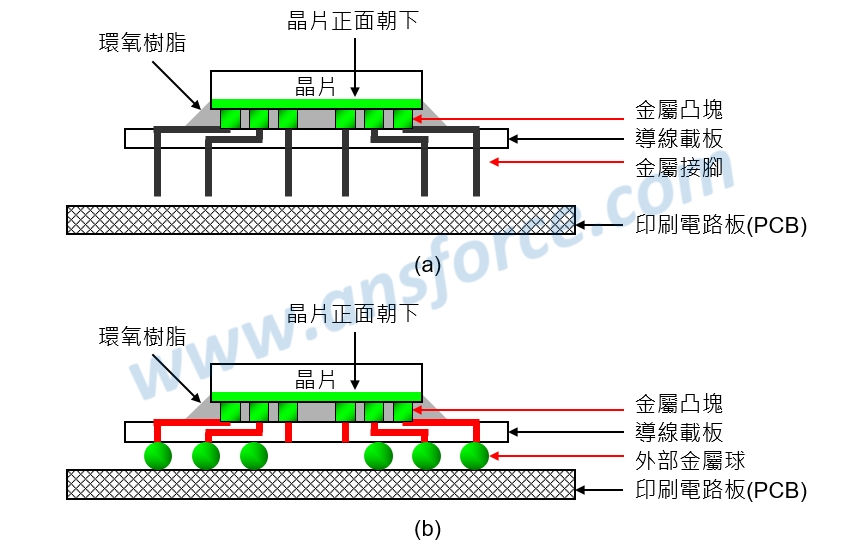
圖二 覆晶封裝的應用。
❒ 覆晶封裝的優缺點
➤優點:大中小型晶片均可使用,不需要打線封裝速度較快,封裝體積較小。
➤缺點:技術困難度較高,但是目前技術已經很成熟。
【請注意】上述內容經過適當簡化以適合大眾閱讀,與產業現狀可能會有差異,若您是這個領域的專家想要提供意見,請自行聯絡作者;若有產業與技術問題請參與社群討論。
【延伸閱讀】其他詳細內容請參考「積體電路與微機電產業,全華圖書公司」。<我要買書>
