文章內容
2.5D與3D立體封裝


❒ 立體封裝技術的定義
除了幾種簡單的系統單封裝(SiP:System in a Package)技術之外,由於手機的尺寸愈來愈小,系統單晶片(SoC:System on a Chip)的發展困難進度趕不上市場需求,因此必須想辦法將更多的晶片堆積起來使體積再縮小,因此目前封裝技術朝向2.5D與3D立體封裝技術發展。
❒ 矽中介板(Silicon interposer)
傳統的系統單封裝(SiP:System in a Package)是使用「導線載板」,把不同的晶片以覆晶封裝的方式以「金屬凸塊(Solder bumps)」黏著在導線載板上,導線載板其實就是一塊塑膠板,上面印刷了許多很小的金屬線路,基本上和印刷電路板(PCB:Printed Circuit Board)差不多,如<圖一>所示,為了使封裝後的體積再縮小,我們必須把導線載板上的垂直孔洞與金屬線路再縮小,因此科學家使用矽做為基板材料取代塑膠板稱為「矽中介板(Silicon interposer)」。
使用矽做為基板就可以使用晶圓廠裡的半導體製程,垂直鑽孔可以使用「蝕刻(Etching)」,或金屬線路可以使用「薄膜成長(Thin film growth)」,而且因為是使用半導體製程,因此垂直孔洞與金屬線路可以更小,有助於封裝後的積體電路體積再縮小。
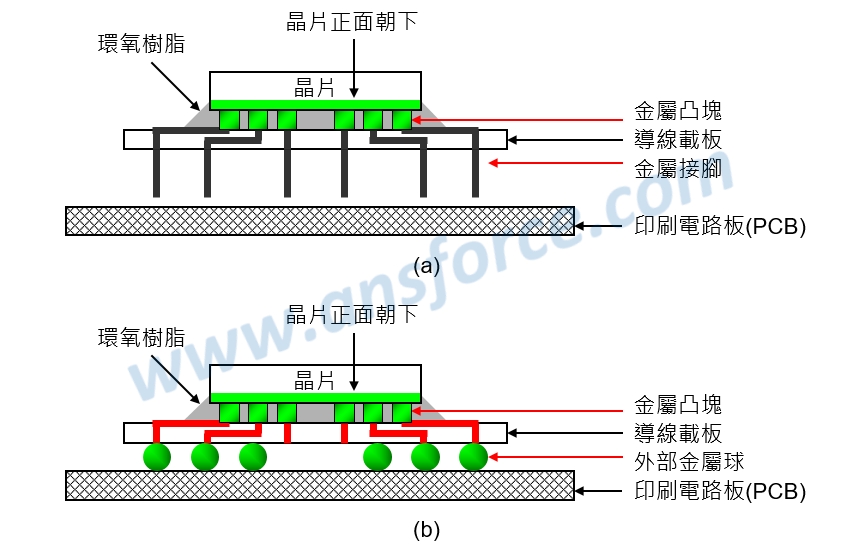
圖一 傳統的系統單封裝使用「導線載板」。
❒ 2.5D立體封裝技術
不使用塑膠製作的「導線載板」,而直接使用矽晶圓製作的「矽中介板(Silicon interposer)」,將數個功能不同的晶片(Chip),直接封裝成具有完整功能的「一個」積體電路(IC),如<圖二>所示,稱為「2.5D立體封裝技術」,為什麼是2.5D呢?主要是因為這種封裝並不是真的把晶片(Chip)堆積成3D立體結構。
由於手機的尺寸愈來愈小,因此必須想辦法將更多的晶片堆積起來使體積再縮小,目前的2.5D封裝技術主要是將處理器、記憶體或其他晶片使用覆晶方式在水平方向上排列,先經由「微凸塊(Micro bump)」連結在「矽中介板(Silicon interposer)」上方,利用矽中介板內微小的水平金屬線來連結左右不同晶片的電子訊號,同時經由「矽穿孔(TSV:Through Silicon Via)」來連結下方的「金屬凸塊(Solder bump)」,最後再經由導線載板連結外部金屬球。知識力www.ansforce.com。
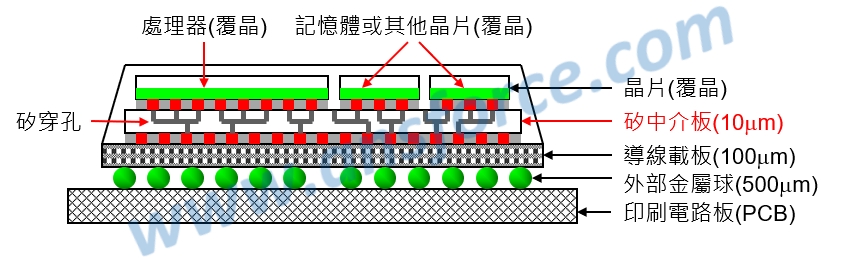
圖二 使用矽中介板與垂直矽穿孔(TSV)的2.5D封裝。
❒ 3D立體封裝技術
矽穿孔(TSV)是在晶圓上以化學蝕刻或雷射的方式鑽孔,再將導電材料(例如:銅、多晶矽、鎢等)填入形成導電的垂直通道,最後將晶片研磨使厚度變薄再加以堆疊,真正的3D封裝技術是指在晶片製作電晶體(CMOS)結構,並且直接製作矽穿孔(TSV)來連結上下不同晶片的電子訊號,如<圖三>所示,在處理器晶片製作電晶體(CMOS)結構再製作矽穿孔(TSV),可以直接將記憶體或其他晶片垂直堆疊在上面,由於要在晶片內直接製作矽穿孔(TSV)困難度極高,目前的技術暫時沒有真的在處理器上製作矽穿孔。
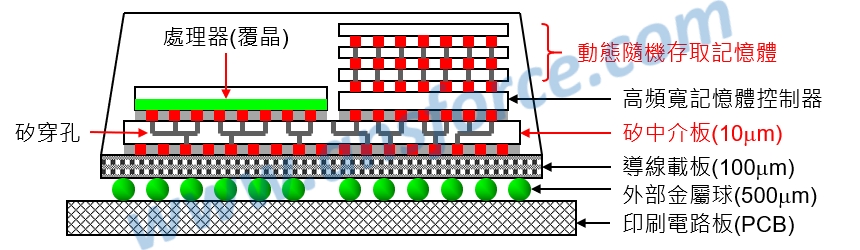
圖三 在處理器、記憶體內直接製作矽穿孔(TSV)來連結上下不同晶片的3D封裝。
❒ 高頻寬記憶體(HBM:High Bandwidth Memory)
由於動態隨機存取記憶體(DRAM)的結構相對簡單,矽穿孔(TSV)技術也比較成熟,因此是目前最先成功製作出3D立體封裝的積體電路,一般中央處理器(CPU)或圖形處理器(GPU)與動態隨機存取記憶體(DRAM)都是分別封裝成不同的積體電路,固定在印刷電路板(PCB)上一起工作,所有的電子訊號必須經由印刷電路板上的介面與匯流排來傳送,速度受到限制,因此廠商開發出新的介面稱為「高頻寬記憶體(HBM:High Bandwidth Memory)」,並且利用高頻寬記憶體控制器來控制多個具有矽穿孔(TSV)經由3D立體封裝的動態隨機存取記憶體(DRAM),如<圖二(b)>所示,再經由矽中介板(Silicon interposer)與中央處理器(CPU)或圖形處理器(GPU)經由2.5D立體封裝整合在一個積體電路內,這樣可以使處理器與記憶體之間在最短的距離進行高速傳輸,這種整合處理器與記憶體的技術由於單價較高目前市場的接受度還不高,不過確是動態隨機存取記憶體(DRAM)未來最有潛力的發展方向。
【請注意】上述內容經過適當簡化以適合大眾閱讀,與產業現狀可能會有差異,若您是這個領域的專家想要提供意見,請自行聯絡作者;若有產業與技術問題請參與社群討論。
【延伸閱讀】以上詳細內容請參考「積體電路與微機電產業,全華圖書公司」。<我要買書>
